消息称三星正考虑将 3D Chiplet 芯粒技术用于 Exynos SoC 中
IT之家 11 月 12 日消息,ZDNet 透露,三星正积极考虑将 3D Chiplet(芯粒)技术运用于自家未来的 Exynos 系列 SoC 中。
知情人士解释说,“三星电子内部正考虑将 3D Chiplet 应用于 Exynos”,并补充道,“我们认为,这样做可以获得显著的好处”。他指出,3D Chiplet 有助于提高 Exynos 的生产效率,从而增强其竞争力。

Chiplet 主要是将一类满足特定功能的 die(裸片),通过 die-to-die 内部互联技术实现多个模块芯片与底层基础芯片封装在一起,形成一个系统芯片,以实现一种新形式的 IP 复用,这与主流 SoC 设计理念存在很大差异。
目前,主流 SoC 系统级单芯片主要是将多个负责不同类型计算任务的计算单元,通过光刻的形式制作到同一块晶圆上,例如手机 AP 芯片主要会集成 CPU、GPU、DSP、ISP、NPU、Modem 等不同单元以及诸多的接口 IP。
相对来说,Chiplet 则是将原本一块复杂的 SoC 芯片,从设计时就先按照不同的计算单元或功能单元对其进行分解,然后每个单元选择最适合的半导体制程工艺进行分别制造,再通过先进封装技术将各个单元彼此互联,最终集成封装为一个系统级芯片组。
随着芯片制程演进到个位数纳米(nm),工艺难度和内部结构的复杂性不断增加,制造流程更加复杂,芯片全流程设计成本大幅增加,这也是 Chiplet 受到关注的一大原因。
再加上近年来“摩尔定律”日趋放缓,在此背景下,Chiplet 被业界寄予厚望,或将从另一个维度来延续摩尔定律的“经济效益”。
目前,NVIDIA、AMD、Intel 等代表性公司正在将 Chiplet 纳入 HPC 系统半导体的开发中。IT之家注意到,加拿大 AI 半导体初创公司 TenStorent 近日也宣布将采用三星代工厂生产 4nm 芯片。
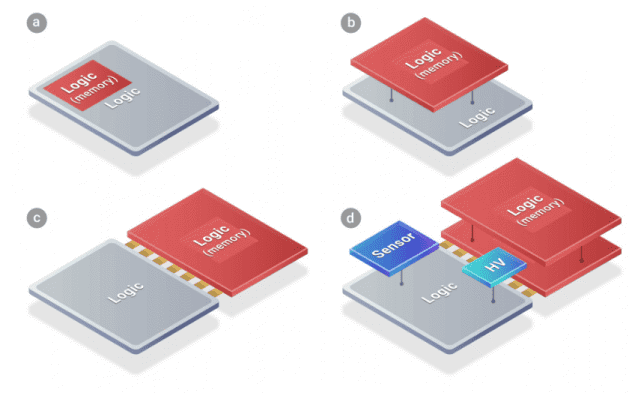
外媒也指出,移动 AP 是最需要尖端代工工艺的领域,对良率非常敏感。因此,通过使用 3D Chiplet 的方式可以实现更稳定的生产。
此外,基于 3D 封装技术,我们还可以进一步减小芯片整体封装尺寸,并且可以通过增加芯片之间的连接性来同时提高带宽和效率。

根据市场研究公司 Counterpoint Research 的数据,今年第二季度移动 AP 市场份额按销售额计算,高通占比 40%,苹果占比 33%,联发科 16%,三星电子仅 7%。
